近日,同济大学精密光学工程技术研究所王占山教授团队在《Surface & Coatings Technology》期刊上发表了题为“The influence of background pressure on microstructure and chemical state of WC/SiC multilayers prepared by magnetron sputtering”的论文。该论文深入探讨了在磁控溅射镀膜过程中,真空腔内残余的本底气体含量对超薄WC/SiC多层膜表界面形貌结构缺陷及膜层化学态的影响规律。此外,论文进一步从原子层面探讨了本底真空度引发WC/SiC多层膜界面形貌结构演变的微观机制,为多层膜磁控溅射制备工艺的优化提供了理论依据。

WC/SiC多层膜反射镜是一类能够高效反射硬X射线的重要光学元件。WC/SiC材料组合因其光滑且稳定的界面而备受关注,其界面质量显著优于传统的W/Si多层膜,可实现最小周期厚度低至2 nm以下的多层膜制备。在这类超薄的周期性薄膜结构中,界面缺陷对实际反射率的影响极为显著。因此,为了提高WC/SiC多层膜的界面质量,并制备出具有良好光学性能的多层膜反射镜,必须在镀膜过程中对各项工艺参数进行充分优化和精确控制。本底真空度是磁控溅射镀膜过程中影响纳米膜层生长的关键因素之一。然而,目前对于本底气压与超薄WC/SiC多层膜界面微结构特性之间的关系尚未充分揭示。针对以上科学问题,研究团队在不同本底真空条件下制备了一系列厚度相近的WC/SiC多层膜,并系统地研究了本底气压对多层膜界面微结构、表面形貌、元素分布以及化学状态的影响规律。
研究团队创建了一套综合表征多层膜表界面形貌结构缺陷综合的方法,该方法以X射线散射技术为核心,并结合光学轮廓仪和原子力显微镜对薄膜表面中高频表面功率谱密度函数进行表征。通过该方法,研究团队深入探究了残余背景气体对WC/SiC多层膜界面粗糙度、界面扩散、界面相关性以及表面形貌的影响规律。研究结果表明,随着镀膜开始前真空腔内本底气压的升高,WC/SiC多层膜的界面粗糙度增大,界面扩散加剧,横向相关长度减小,纵向相关性降低。WC/SiC多层膜界面形貌质量的下降最终表现为表面高频粗糙度的增大。(图1)
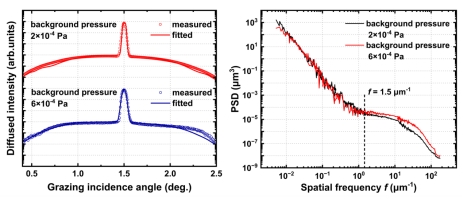
图1在2 × 10−4Pa和6× 10−4Pa本底气压下制备的WC/SiC多层膜的XRS测试结果;在2 × 10−4Pa和6× 10−4Pa本底气压下制备的WC/SiC多层膜的表面功率谱密度函数。
研究团队进一步利用X射线光电子能谱(XPS)技术,对在不同本底真空度下制备的WC/SiC多层膜中的元素分布及膜层化学状态进行了系统研究,并建立了本底气压影响WC/SiC多层膜表界面形貌结构的微观机制。在低本底气压条件下制备的WC/SiC多层膜中,WC膜层中的游离碳原子向SiC膜层发生迁移,C原子主要分布在SiC膜层中。在迁移过程中,碳原子对膜层界面起到了浸润作用,从而有效降低了WC/SiC多层膜的界面粗糙度。然而,当真空腔内本底气压升高后,更多的残余氧原子进入SiC膜层,并优先与Si原子发生化学反应,生成SiO2化合物。此时,SiC膜层内Si原子之间的空隙大量地被氧原子占据,导致游离碳原子向SiC膜层内的迁移受到阻碍。因此,可以合理推测,在高本底气压条件下制备的WC/SiC多层膜中,由游离碳原子迁移导致的膜层界面平整度和清晰度的提升难以实现。(图2)

图2在2 × 10−4Pa和6× 10−4Pa本底气压下制备的WC/SiC多层膜深度方向上W、Si、C和O元素的相对原子浓度;在2 × 10−4Pa和6× 10−4Pa本底气压下制备的WC/SiC多层膜的C 1s精细谱和Si 2p精细谱。
本论文的研究结果对于优化薄膜沉积条件,研制具有良好界面质量和光学性能的WC/SiC多层膜反射镜器件具有重要的指导意义。为制备高性能的WC/SiC多层膜,磁控溅射镀膜前真空腔内的残余气体压强应控制在2 × 10⁻⁴ Pa以下。
同济大学张哲助理教授和蒋励工程师为本论文的共同通讯作者,同济大学博士研究生王子乐和博士研究生李彤洲为本论文的共同第一作者,对论文做出重要贡献的合作者还包括同济大学齐润泽助理教授,黄秋实教授,张众教授和王占山教授。该项研究工作得到了国家自然科学基金和国家重点研发计划项目的资助。
论文链接:https://doi.org/10.1016/j.surfcoat.2025.132148
